Popular Keywords
- About Us
-
Research Report
Research Directory
Semiconductors
LED
Consumer Electronics
Emerging Technologies
- Selected Topics
- Membership
- Price Trends
- Press Center
- News
- Events
- Contact Us
- AI Agent
CoWoS
News

[News] TSMC Says CoWoS Offers Industry’s Largest Reticle-Size Packaging Amid Intel EMIB Rivalry; CoPoS Advances
TSMC holds its earnings call today, with its response closely watched amid rising industry interest in rival Intel’s advanced packaging technologies, including EMIB. In response, according to TechNews, TSMC Chairman and CEO C.C. Wei states that the company continues to offer the industry’s large...
News

[News] TSMC Advances Panel-Level Packaging, CoPoS Pilot Line Reportedly Set for June Completion, 2028–29 Ramp Eyed
Ahead of TSMC’s earnings call later this week, the spotlight is once again on its advanced packaging roadmap—and CoWoS is no longer the only story. According to Commercial Times, TSMC’s CoPoS (Chip-on-Panel-on-Substrate) pilot line has already begun tool deliveries to R&D teams in February...
News

[News] ASE Buys NT$2.8B Zhunan Facility, Packaging Orders Reportedly Span NVIDIA, AMD, and More
ASE has been actively expanding on the back of AI-driven demand for advanced packaging. According to Economic Daily News, ASE has made another expansion move, with its subsidiary SPIL on the 13th spending NT$2.801 billion to acquire a plant in Zhunan, Miaoli, previously owned by United Renewable Ene...
News

[News] MediaTek Reportedly Secures Google v7e, v8e TPU Orders, Requests 7-Fold CoWoS Increase from TSMC
While Broadcom signaled strong demand from Google TPUs via Anthropic during last week’s earnings call, another leading Taiwanese ASIC supplier, MediaTek, is reported by the Economic Daily News to have secured orders for Google’s v7e and v8e TPUs. Supply chain sources cited by the report note tha...
News
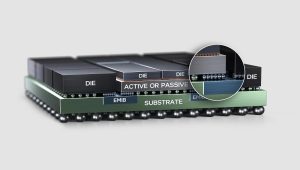
[News] Intel’s EMIB Reportedly Gains Traction with AI ASIC, Smartphone Clients, Could Package TSMC Dies
Recent reports that Apple and Qualcomm are recruiting engineers with EMIB (Embedded Multi-die Interconnect Bridge) expertise suggest Intel’s packaging technology is regaining momentum—helped in part by the tight squeeze on TSMC’s capacity. According to the Commercial Times, the shift indicates...
- Page 1
- 22 page(s)
- 107 result(s)






