Popular Keywords
- About Us
-
Research Report
Research Directory
Semiconductors
LED
Consumer Electronics
Emerging Technologies
- Selected Topics
- Membership
- Price Trends
- Press Center
- News
- Events
- Contact Us
- AI Agent
advanced packaging
News

[News] TSMC Says CoWoS Offers Industry’s Largest Reticle-Size Packaging Amid Intel EMIB Rivalry; CoPoS Advances
TSMC holds its earnings call today, with its response closely watched amid rising industry interest in rival Intel’s advanced packaging technologies, including EMIB. In response, according to TechNews, TSMC Chairman and CEO C.C. Wei states that the company continues to offer the industry’s large...
News
[News] SJ Semiconductor Reportedly Wins IPO Nod as China Bets on Advanced Packaging
China’s drive for semiconductor self-reliance is advancing, with fresh momentum in advanced packaging. According to South China Morning Post, SJ Semiconductor, a key player in China’s advanced chip packaging sector, has secured approval to list on Shanghai’s STAR Market. The report notes that ...
News
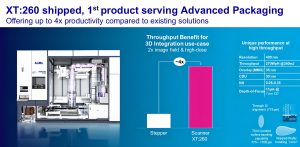
[News] Chip Tool Giants Accelerate Advanced Packaging Push, Led by ASML, Tokyo Electron, and Others
As back-end processes take on a larger role in the AI chip era, advanced packaging equipment is rising in strategic importance. According to Hankyung, leading chip equipment makers—including ASML, Applied Materials, Tokyo Electron (TEL), and Lam Research—are moving decisively into the advanced p...
News

[News] TSMC Advanced Packaging CapEx Projected to Grow 24% CAGR in 2025–27; AP7 Eyes WMCM, CoPoS
TSMC is scheduled to hold a media tour in Chiayi on the 22nd, marking the first time its Chiayi AP7 site will be opened to local media. According to Commercial Times, construction at TSMC’s Chiayi facilities is progressing at full speed. Supply-chain sources note that AP7 Plant 2 began equipment i...
News

[News] TSMC Reportedly Expands WMCM Packaging for Apple, Capacity May More Than Double by 2027
TSMC has continued to ramp up investment in advanced packaging. According to Commercial Times, alongside its transition to a 2nm process for the A20-series chip used in the iPhone 18, Apple is set to upgrade packaging technology from the current InFO (Integrated Fan-Out) process to WMCM (Wafer-Level...
- Page 1
- 18 page(s)
- 90 result(s)






