Popular Keywords
- About Us
-
Research Report
Research Directory
Semiconductors
LED
Consumer Electronics
Emerging Technologies
- Selected Topics
- Membership
- Price Trends
- Press Center
- News
- Events
- Contact Us
- AI Agent
interposer
News
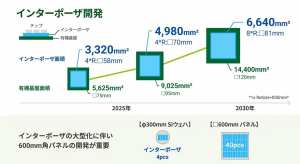
[News] Rapidus Reportedly to Unveil Glass Substrate Interposer Prototype, Eyes 2028 Production
As SEMICON Japan opens today (December 17), Nikkei reports that semiconductor heavyweights—including NVIDIA, Intel, Micron, and TSMC—are set to participate. Yet the biggest buzz may center on Rapidus, the Japanese foundry expected to unveil the world’s first interposer prototype cut from a sin...
News

[News] Samsung Reportedly Develops Glass Interposers for Packaging, Leveraging Corning’s Glass
According to a report from Business Korea, citing SEDaily, Samsung Electronics’ Device Solutions (DS) division has begun developing “glass interposers,” a next-generation packaging material. The goal is not only to replace the expensive silicon interposers but also to enhance performance. M...
News

[News] SK hynix Rumored to Team up with Amkor to Secure HBM Advantage over Samsung
As Samsung eagerly accelerates its pace on the HBM3e certification with NVIDIA, SK hynix, the current HBM market leader, is reportedly planning another move to strengthen its relationship with the AI giant. According to a report by Korean media Money Today, SK hynix is teaming up with Amkor Technolo...
News

[News] Rumored AI Chip Demand Spurs Price Hikes at TSMC, UMC, ASE
TSMC's CoWoS advanced packaging capacity shortage is causing limitations in NVIDIA's AI chip output. Reports are emerging that NVIDIA is willing to pay a premium for alternative manufacturing capacity outside of TSMC, setting off a surge in massive overflow orders. UMC, the supplier of interposer ma...
News

[News] NVIDIA Establishes Non-TSMC CoWoS Supply Chain, UMC Doubles Interposer Capacity
According to a report from Taiwan's Commercial Times, NVIDIA is aggressively establishing a non-TSMC CoWoS supply chain. Sources in the supply chain reveal that UMC is proactively expanding silicon interposer capacity, doubling it in advance, and now planning to further increase production by over t...
- Page 1
- 2 page(s)
- 6 result(s)






